Davon profitieren Sie
Ihre Vorteile
Hoher optischer Kontrast
Erfassung bis in den DUV-Wellenlängenbereich möglich
Maximale Auflösung
Quantitative Ermittlung der Strukturbreiten von 50 nm bis 2 µm
Vielfältige Dimensionalität
Sowohl 1D Liniengitter und 2D Kreuz-/Kreisgitter verfügbar
Optische Evaluation
Qualitätssicherung durch Astigmatismustest oder AFM-Spitzengeometrie
Große Anwendungsbreite
Durch hochauflösende Optiken (UVA, CLSM, REM und AFM)
Faire Konditionen
Unkomplizierter Direktvertrieb sichert attraktiven Preis
Mikroskopiernormale
| Nanoskalige AFM-CD Standard | Nanoskaliger Linienbreiten/ Gitterperioden-Standard | AFM-Spitzen Charakterisierer | ||
|---|---|---|---|---|
| Gittertyp: | 1-dimensional | x | x | x |
| 2-dimensional | x | |||
| zirkular | x | |||
| Linienbreiten (nominell): | 50 nm – 80 nm | x | ||
| 80 nm – 300 nm | x | x | ||
| 300 nm – 800 nm | x | x | x | |
| 800 nm - 2 µm | x | |||
| Geeignet für: | Optische Mikroskopie | x | ||
| (deep ultraviolet microscopy) UVM, (confocal laser scanning microscopy) CLSM | x | |||
| Rasterkraftmikroskopie (AFM) | x | x | x |
Produkte
AFM CD standard
Spezifikationen
Substrat Material: <110> Si Chipgröße: 8×8 mm² Oberflächengenauigkeit: <1 nm Findestrukturen Gräben im Si-Substrat Tiefe: 250 nm Gittertypen 1-dimensional Gittergröße ca. 10×10 µm² Linienbreiten (CD) nominell: 50 nm, 100 nm, 150 nm, 200 nm, 300 nm, 800 nm Linienbreitenabweichung längs der Linie (innerhalb eines 1 µm langen Bereichs): <3 nm 1σ Perioden 1 µm + CD-Wert Unsicherheit der Hauptperiode: 3 nm 1σ Strukturtiefe 250 nm Kantenradius <15 nm Kantenrauigkeit <5 nm (p-p) Flankenwinkel 89° AFM-Spitzencharakterisierer
Spezifikationen
Substrat Material: <110> Si Chipgröße: 8×8 mm² Oberflächenrauigkeit: <1 nm Findestrukturen Gräben im Si-Substrat·Tiefe: 1 µm Gittertypen 1-dimensional Gittergröße normalerweise 10×10 µm² Linienbreiten (CD) nominell: 300 nm, 500 nm, 800 nm Linienbreitenabweichung längs der Linien (innerhalb eines 10 µm langen Bereichs): <5 nm 1σ Perioden 1 µm + CD value Unsicherheit der Hauptperiode: 3 nm 1σ Strukturtiefe ca. 1 µm Kantenradius <2 nm Kantenrauigkeit ± 4 nm (3σ) Flankenwinkel 89° Strukturdetails
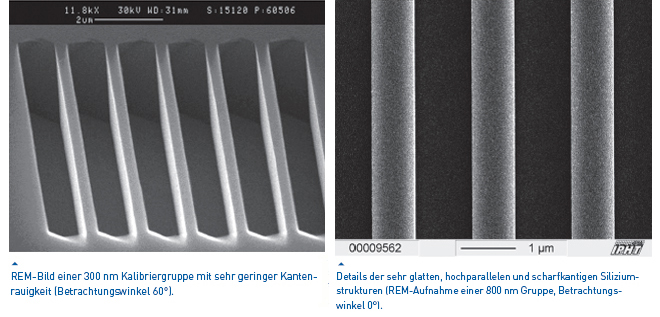
Ermittlung der AFM-Spitzengeometrie
Linienbreitennormal
Spezifikationen
Substrat Material: Quarz Chipgröße: 8×8 mm² Schicht nanokristallines Silizium Dicke: 25 nm Chiphalter Abmessungen: 76×26×2 mm Material: Aluminiumlegierung, eloxiert Findestrukturen Au Dicke: 100 nm Gittertypen 1-dimensional (Liniengitter für x+y) 2-dimensional (Kreuzgitter) zirkular (Kreisgitter) eine gesonderte Einzelstruktur zur CD-Bestimmung auf einer Seite des 1-dimensionalen Gitters Gittergröße normalerweise 10×10 μm² Linienbreiten (CD) nominell: 80 nm, 100 nm, 115 nm, 130 nm, 200 nm, 250 nm, 350 nm, 500 nm, 2 μm Linienbreitenabweichung längs der Linie (innerhalb eines 6 μm langen Bereichs): 8 nm 1σ Perioden 160 nm, 200 nm, 230 nm, 260 nm, 300 nm, 400 nm, 500 nm, 700 nm, 1000 nm, 4 μm Unsicherheit der Hauptperiode: 3 nm 1σ Rundheit der Kreisgitter ± 0.6 % Abweichung von der Hauptperiode in x- und y-Richtung (± 1 nm for 160 nm Gitter) Chip- und Strukturbeschreibung
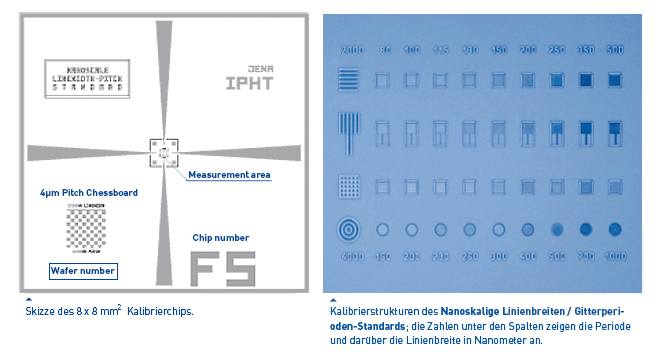
Woran wir schon mitgearbeitet haben?